МЄЙтЛЎЦЌЛњКЭОЇдВЛЎЦЌЛњгаЪВУДЧјБ№
РДдДЃКЕТгЎЁЄvwinЬхг§ОЋУмЗЂВМЪБМфЃК2025-07-21 08:46:21
дкАыЕМЬхжЦдьМАЮЂЕчзгЗтзАСьгђжаЃЌЁАЛЎЦЌЁБЪЧаОЦЌДгОЇдВЩЯЗжРыЕФЙиМќЙЄвеВНжшЁЃЫцзХЙЄвеОЋЖШЕФВЛЖЯЬсЩ§ЃЌЛЎЦЌММЪѕвВОРњСЫДгДЋЭГЛњаЕЕЖТжЧаИюЃЌЕНШчНёИпОЋЖШМЄЙтЛЎЦЌЕФММЪѕбнНјЁЃБОЮФНЋШЋУцЗжЮіМЄЙтЛЎЦЌЛњгыОЇдВЛЎЦЌЛњЕФЧјБ№ЃЌАяжњЦѓвЕИљОнгІгУашЧѓзіГіКЯРэбЁдёЁЃ
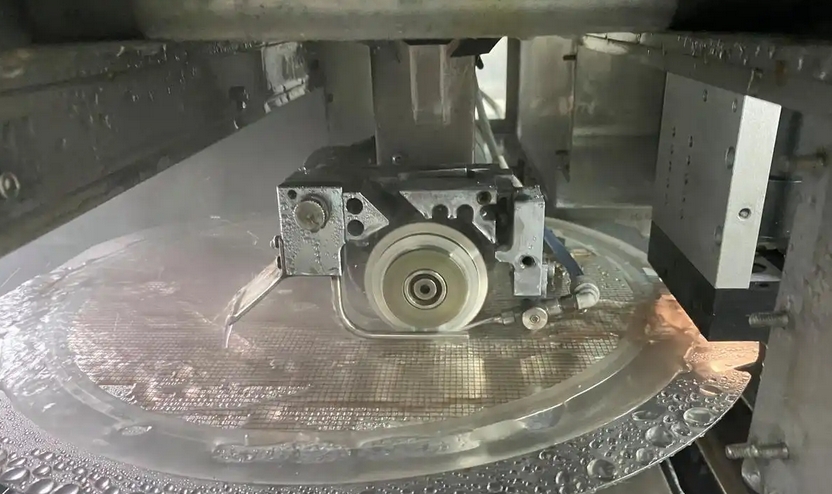
вЛЁЂЖЈвхМАдРэНтЮі
1. ОЇдВЛЎЦЌЛњЃЈЛњаЕЪНЛЎЦЌЛњЃЉ
ОЇдВЛЎЦЌЛњжївЊВЩгУН№ИеЪЏЕЖТжЃЈBladeЃЉЖдОЇдВНјааЧаИюЃЌЦфВйзїЙ§ГЬАќРЈЖдзМОЇдВЭМАИЕФНжЕРЯпЃЌШЛКѓЭЈЙ§ИпЫйа§зЊЕФЕЖТжбиЛЎЦЌЯпЧаИюОЇдВЃЌзюжеЪЕЯжаОЦЌЗжРыЁЃ
КЫаФдРэЃК
ЕЖТждкОЇдВЩЯаЮГЩЮяРэЧаИюЃЌЭЈЙ§ЫЎРфгыМѕе№ПижЦЃЌЗРжЙОЇдВБРБпгыПХСЃЮлШОЁЃ
2. МЄЙтЛЎЦЌЛњ
МЄЙтЛЎЦЌЛњдђВЩгУИпФмМЄЙтЪјЃЈЭЈГЃЮЊзЯЭтЁЂТЬЙтЛђКьЭтМЄЙтЃЉОлНЙгкОЇдВБэУцЃЌЭЈЙ§МЄЙтЕФИпЮТШкЛЏЛђЦјЛЏзїгУЪЕЯжЗЧНгДЅЪНЧаИюЁЃ
КЫаФдРэЃК
МЄЙтФмСПОлНЙдкМЋаЁЧјгђЃЌЭЈЙ§ОжВПМгШШЛђБЌЦЦЃЌЪЕЯжИпОЋЖШЛЎЦЌЃЌЪЪКЯЖдИпгВДрВФСЯЛђБЁЦЌНсЙЙЕФЮоЫ№ЧаИюЁЃ
| ЖдБШЮЌЖШ | ОЇдВЛЎЦЌЛњЃЈЛњаЕЃЉ | МЄЙтЛЎЦЌЛњЃЈЗЧНгДЅЃЉ |
|---|---|---|
| ЧаИюЗНЪН | ЮяРэЧаИюЃЈЕЖТжЃЉ | ФмСПЧаИюЃЈМЄЙтЃЉ |
| гІСІгыШШгАЯь | ДцдкНЯДѓЛњаЕгІСІгыЮЂеёЖЏ | ШШгАЯьЧјаЁЃЌЮоЛњаЕгІСІ |
| ЪЪгУВФСЯ | ЙшЁЂВЃСЇЕШБъзМОЇдВ | ВЃСЇЁЂЬеДЩЁЂРЖБІЪЏЁЂИДКЯВФСЯЕШ |
| ОЋЖШгыБпдЕжЪСП | ШнвзБРБпЁЂЫщСб | ОЋЯИЃЌБпдЕећЦыЙтЛЌ |
| ГЩБО | ЩшБИГЩБОЯрЖдНЯЕЭ | ГѕЦкЭЖШыИпЃЌЕЋСМТЪИќгХ |
| ЕЖЦЌИќЛЛгыКФВФ | ЕЖТжашЖЈЦкИќЛЛ | ЮоашЕЖТжЃЌЮЌЛЄМђЕЅ |
| ЧаИюКёЖШ | КёОЇдВЪЪХфадЧП | БЁОЇдВКЭШсадЛљВФгХЪЦУїЯд |
Ш§ЁЂгІгУГЁОАЖдБШ
ОЇдВЛЎЦЌЛњГЃМћгІгУЃК
* ДЋЭГЙшЛљаОЦЌЩњВњ
* БъзМICОЇдВЧаИю
* ГЩБОУєИааЭЯюФП
МЄЙтЛЎЦЌЛњГЃМћгІгУЃК
* ИпЖЫЙІТЪЦїМўЃЈSiCЁЂGaNОЇдВЃЉ
* MicroLEDЁЂMEMSЦїМўЧаИю
* ШсадЯдЪОЁЂЩуЯёЭЗФЃзщЁЂВЃСЇИЧАхЕШвьаЮНсЙЙЛЎЦЌ
ЫФЁЂИпЦЕЮЪЬтД№вЩзЈЧј
1. МЄЙтЛЎЦЌЛњКЭОЇдВЛЎЦЌЛњФФИіКУЃП
етИіЮЪЬтВЂЮоОјЖдД№АИЃЌШЁОігкгІгУГЁОАЃК
* ШєФњжївЊМгЙЄБъзМЙшЦЌЁЂХњСПЛЏашЧѓДѓЁЂЖдГЩБОУєИаЃЌдђДЋЭГОЇдВЛЎЦЌЛњвРШЛОпгагХЪЦЃЛ
* ШєФњУцЯђИпИНМгжЕВњЦЗЁЂЖдБпдЕжЪСПЁЂСМТЪЁЂЮоЫ№вЊЧѓИпЃЌШчMEMSЛђЯШНјЗтзАЃЌдђМЄЙтЛЎЦЌЛњИќОпОКељСІЁЃ
НЈвщЃКЦѓвЕПЩИљОнВњЦЗВФжЪЁЂГпДчКёЖШЁЂЧаИюОЋЖШЁЂЩњВњСМТЪКЭГЩБОдЄЫузлКЯЦРЙРЁЃ
2. МЄЙтЛЎЦЌЛњВЮЪ§дѕУДЩшЖЈЃП
МЄЙтЛЎЦЌЛњЕФЧаИюжЪСПКмДѓГЬЖШЩЯвРРЕВЮЪ§ЩшЖЈЕФКЯРэадЃЌжївЊВЮЪ§АќРЈЃК
* МЄЙтРраЭгыВЈГЄЃКГЃМћгазЯЭтЃЈ355nmЃЉЁЂТЬЙтЃЈ532nmЃЉЁЂКьЭтЃЈ1064nmЃЉЃЌзЯЭтЪЪгУгкЮЂУзМЖИпОЋЖШЧаИюЃЛ
* ЙІТЪЃЈWЃЉЃКИљОнВФСЯКёЖШгыгВЖШЩшжУЃЌвЛАуЮЊ3W\~15WЃЛ
* ЩЈУшЫйЖШЃЈmm/sЃЉЃКгАЯьЧаИюЫйЖШгыЩеЪДГЬЖШЃЛ
* ТіГхЦЕТЪЃЈKHzЃЉЃКЕїећМЄЙтЕуЕФУмЖШЃЛ
* НЙОргыОлНЙЙтАпДѓаЁЃКашНсКЯЯдЮЂОЕЯЕЭГЕїЪдЃЛ
* ИЈжњЦјЬхЃЈЕЊЦјЁЂбѕЦјЃЉЃКЗРжЙЩеБпЁЂРфШДМЄЙтШШаЇгІЁЃ
ЭЈГЃЩшБИГЇМвЛсЬсЙЉеыЖдВЛЭЌВФСЯЕФВЮЪ§ФЃАхЃЌПЭЛЇашдкДЫЛљДЁЩЯНјааОЋЕїЁЃ
3. ЙЬОЇЛњКЭЬљЦЌЛњЕФЧјБ№ЃП
ЙЬОЇЛњКЭЬљЦЌЛњЫфЖМгУгкЕчзгдЊЦїМўЕФзщзАЃЌЕЋзїгУЁЂЙЄвеСїГЬМАЖдЯѓЭъШЋВЛЭЌЁЃ
| ЯюФП | ЙЬОЇЛњ | ЬљЦЌЛњ |
|---|---|---|
| жївЊЙІФм | НЋОЇСЃЃЈDieЃЉЙЬНгЕНЛљАхЛђв§ЯпПђЩЯ | НЋSMTЦїМўЬљзАЕНPCBКИХЬЩЯ |
| гІгУЛЗНк | АыЕМЬхЗтзАЧАЕРЙЄве | SMTБэУцЬљзАЙЄве |
| ОЋЖШвЊЧѓ | ИпЃЌашдкЯдЮЂЪгОѕЯТВйзї | ИпЫйЬљзАЃЌЕЋШнВюТдДѓ |
| ВФСЯЖдЯѓ | ЙшЦЌDieЁЂТуаОЦЌЕШ | ЕчзшЁЂЕчШнЁЂICЁЂLEDЁЂBGAЕШ |
| ЕфаЭЩшБИЦЗХЦ | ASMЁЂESECЁЂГЄДЈЁЂЕТгЎЁЄvwinЬхг§ОЋУм | ИЛЪПЁЂбХТэЙўЁЂЫЩЯТЁЂJUKIЕШ |
змНсЃКЙЬОЇЛњЪЧАыЕМЬхЗтзАЧАЕРКЫаФЩшБИЃЌЖјЬљЦЌЛњЪєгкЕчзгзАХфНзЖЮЕФЩшБИЃЌСНИіЯЕЭГЯрИЈЯрГЩЁЃ
ШєФуЪЧДЋЭГОЇдВГЇЛђЙІТЪЦїМўЦѓвЕЃЌНЈвщЃК
* БъзМаОЦЌМгЙЄ Ёњ бЁгУОЇдВЛЎЦЌЛњЃЛ
* ЗЧЙшИпЖЫВФСЯЁЂвьаЮЧаИю Ёњ бЁдёМЄЙтЛЎЦЌЛњИќКЯЪЪЃЛ
* ШєгаПЭЛЇЖЈжЦЛЏашЧѓЁЂашвЊИпОЋЖШгыЮоГОзївЕЃЌМЄЙтЗНАИдкЮДРДИќОпЗЂеЙЧБСІЁЃ
ЫцзХжЧФмжЦдьЕФЧїЪЦЃЌМЄЙтЛЎЦЌММЪѕНЋж№ВНЬцДњВПЗжЛњаЕЛЎЦЌЛњЪаГЁЃЌЬиБ№ЪЧдкИпПЩППадгыИпИНМгжЕЮЂЕчзгаавЕжаЃЌГЩЮЊЩшБИЩ§МЖЕФживЊЗНЯђЁЃ
ШчашНјвЛВНСЫНтМЄЙтЛЎЦЌНтОіЗНАИЛђЩшБИВЮЪ§ХфжУЃЌЭЦМіЙизЂЕТгЎЁЄvwinЬхг§ОЋУмЕШзЈвЕГЇЩЬЃЌЫћУЧдкЖрРраЭВФСЯЧаИюЁЂздЖЏЩЯЯТСЯЁЂЪгОѕЖЈЮЛПижЦЕШЗНУцгЕгаГЩЪьНтОіЗНАИКЭММЪѕжЇГжЁЃ
ШчашЬсЙЉЖЈжЦбЁаЭНЈвщЃЌвВПЩСєбдОпЬхашЧѓЃЌЮвПЩвдЮЊФњЦЅХфЯъЯИЗНАИЁЃ
ЭЦМіаТЮХ
-
355nmМЄЙтДђБъЛњНЙОрдѕУДЕїЃПЭъећЕїНЙЗНЗЈжИФЯ
дкЪЙгУ 355nmМЄЙтДђБъЛњ ЪБЃЌНЙОрЕїНкЪЧгАЯьДђБъаЇЙћЕФЙиМќЛЗНкЁЃНЙОрШчЙћУЛЕїКУЃЌВЛНіЛсЕМжТЭМ...
2025-09-04 -
ЮЂСїПиаОЦЌжЦдьЮЊЪВУДвЊЪЙгУМЄЙтКИНгЛњ
дкЩњУќПЦбЇЁЂвНСЦМьВтЁЂЛЗОГМрВтвдМАаТВФСЯбаОПжаЃЌЮЂСїПиаОЦЌЃЈMicrofluidic ChipЃЉ вбГЩЮЊВЛПЩ...
2025-09-01 -
ЪжГжЪНМЄЙтДђБъЛњКЭЬЈЪНЛњФФИіКУЃПгХШБЕуЖдБШ
дкЯжДњжЦдьвЕКЭИіадЛЏМгЙЄСьгђЃЌМЄЙтДђБъЛњвђЦфОЋЯИЁЂЛЗБЃЁЂИпаЇЕФЬиЕуБЛЙуЗКгІгУЁЃЮоТлЪЧН№ЪєСу...
2025-08-28 -
МЄЙтДђБъЛњзжЬхЭсСЫдѕУДЕїећЃЈзлКЯХХВщгыНтОіжИФЯЃЉ
МЄЙтДђБъЛњзжЬхДђБъГіЯжЭсаБЃЌБОжЪЩЯЪЧвЛИіЁАШэМў-гВМўЁБСЊЖЏЕФЯЕЭГадЮЪЬтЁЃЦфКЫаФдкгкМЦЫуЛњжа...
2025-08-25 -
ЦЄУыМЄЙтЧаИюЛњЧаИюНКЦЄаЇЙћгыгАЯьЯъНтЃЈКЌГЃМћЮЪЬтгыЙЄвеВЮЪ§БэЃЉ
БОЮФЯъЯИНщЩмЦЄУыМЄЙтЧаИюЛњдкНКЦЄМгЙЄжаЕФгІгУЃЌЗжЮіЧаИюгХЪЦгыПЩФмгАЯьЃЌВЂИНГЃМћЮЪЬтНтД№КЭВЛ...
2025-08-23










